La puce informatique saute dans la troisième dimension
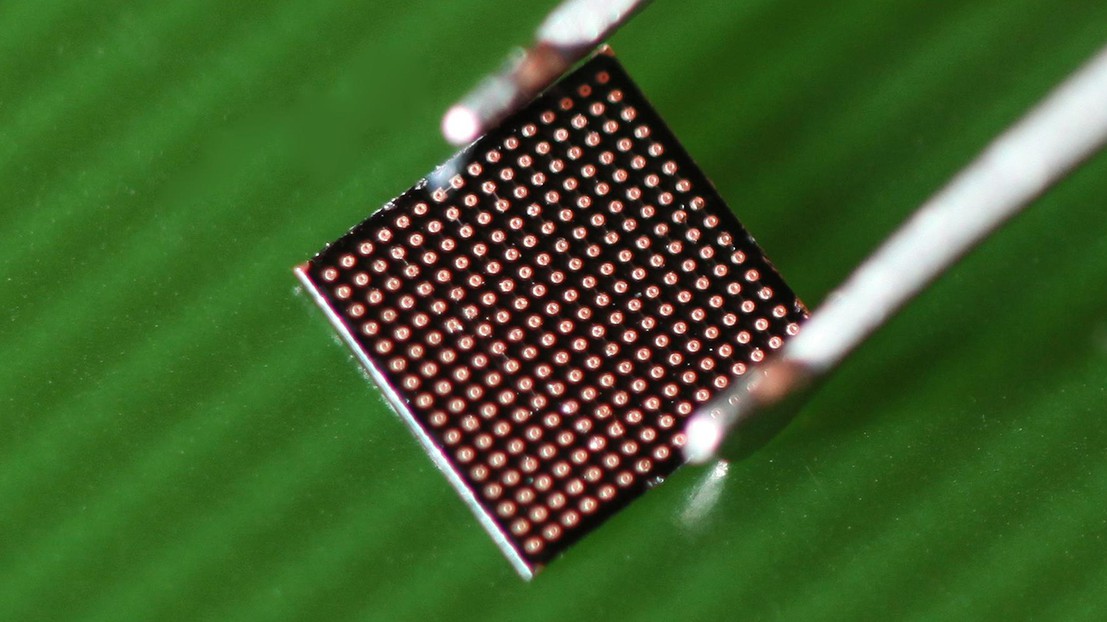
© 2012 EPFL
Empilées plutôt que mises côte-à-côte, des puces d’une nouvelle génération, en trois dimensions, ont été réalisées par des chercheurs de l’EPFL. Grâce à cette technologie, les ordinateurs seront plus rapides, plus efficaces et pourront cumuler davantage de fonctions.
C’est l’une de ces inventions qui s’intégrera discrètement au cœur de nos appareils informatiques et téléphones… tout en révolutionnant en profondeur le monde de l’électronique. Des chercheurs de l’EPFL ont développé un prototype de puce en trois dimensions. Elle consiste en trois ou davantage de processeurs empilés et connectés verticalement les uns sur les autres. A la clé: davantage de rapidité, de mémoire, de force de calcul, de fonctions et une meilleure connectivité sans fil pour nos ordinateurs.
Plusieurs puces fonctionnelles ont été créées par le Laboratoire de systèmes microélectroniques (LSM) de l’EPFL. Une méthode de fabrication performante et fiable a également été mise au point. Yusuf Leblebici, directeur du LSM, présente le fruit du travail de son équipe aux spécialistes aujourd’hui à Paris, lors du congrès «2012 Interconnect Network Architectures Workshop».
L’Ecole se place ainsi dans le peloton de tête de la recherche sur cette technologie, qui mobilise de nombreuses compagnies et équipes académiques dans le monde. «C’est l’étape suivante la plus logique en matière de développement électronique, car elle permet un gain très important en matière d’efficacité», relève Yusuf Leblebici.
Jusque là, les puces ne pouvaient être assemblées qu’horizontalement par des connections sur leurs côtés. Là, elles sont connectées verticalement par plusieurs centaines de microtubes de cuivre très fins. Ces fils passent par autant d’ouvertures, appelées Through-Silicon-Vias (TSV), réalisées au cœur même de la couche de silicium de chaque puce.
Aussi des processeurs en 3D
«Cette superposition réduit la distance entre les circuits et améliore ainsi considérablement la rapidité des échanges de données», décrit Yuksel Temiz, chercheur au LSM, qui fait sa thèse sur le sujet.
Pour parvenir à ce résultat, l’équipe a dû résoudre de nombreuses difficultés, telles que la fragilité des liaisons de cuivre ou des supports qui, miniaturisés à l’extrême, soit jusqu’à une épaisseur de 50 micromètres, devenaient aussi fins qu’un cheveu. «En trois ans de travail, nous avons fabriqué et testé des milliers de connections TSV, jusqu’à plus de 900 fonctionnant simultanément, affirme Yusuf Leblebici. Nous disposons maintenant d’un procédé de production véritablement efficace.» Et d’ajouter que le laboratoire a également réalisé des processeurs multi-core en 3D, connectés par un réseau de TSV.
Cette technologie sera d’abord mise à disposition de certaines équipes de recherche académiques pour être développée avant d’être commercialisée.